Capacități de asamblare BGA
Asamblare BGA de precizie pentru electronice înalt fiabile (medicale/industriale/auto/telecom). Aliniere avansată cu raze X, lipire prin reflow și tehnologie de lipire fără goluri asigură performanță stabilă pentru componente BGA, QFN, CSP și micro-BGA.
✅ Poziționare ghidată de raze X
✅ Lipire fără goluri
✅ Suport pentru componente Micro-BGA/QFN/CSP
Descriere
Asamblarea BGA se referă la procesul de montare și sudare a circuitelor integrate (IC) ambalate în tehnologia BGA pe plăci de circuit imprimat (PCB). Pachetele BGA utilizează bile de lipit dispuse pe partea inferioară a cipului (în loc de pini) pentru a se conecta la zonele de contact de pe PCB,
permițând conexiuni dense și fiabile pentru electronice avansate.

Caracteristici de bază:
· Densitate ridicată a componentelor: Bilele de lipit sunt aranjate într-o rețea, permițând sute sau mii de conexiuni pe o suprafață mică (esențial pentru dispozitive compacte precum echipamentele medicale purtabile, unități electronice automate - ECU).
· Performanță termică și electrică superioară: Conexiunile scurte prin bile de lipit reduc întârzierea semnalului/EMI și îmbunătățesc disiparea căldurii (ideal pentru circuite integrate de putere în sisteme de control industrial, sisteme EV).
· Siguranță mecanică: Bilele de lipit absorb vibrațiile/șocurile (conforme cu standardele auto IATF 16949, standardele industriale IEC 60335).
Proces principal de asamblare:
· Imprimare prin șablon: Depunerea pastei de lipit pe zonele BGA ale plăcii de circuit imprimat (PCB).
· Poziționare: Alinierea precisă a cipului BGA pe PCB (prin mașini automate cu aliniere optică/laser).
· Sudare prin reflow: Încălzire controlată pentru a topi bilele de lipit, formând conexiuni fiabile.
· Inspecție: Testare cu raze X (obligatorie, deoarece conexiunile sunt ascunse) pentru detectarea defectelor (de exemplu, lipituri reci, goluri); AOI pentru alinierea exterioară.
· Reparații: Echipamente specializate pentru eliminarea/înlocuirea BGA în cazul în care sunt descoperite defecte.
Aplicații în Diversi Domeniuri:
· Medical: Procesoare pentru scanere MRI/CT, microcontrolere pentru dispozitive purtabile (conforme ISO 13485).
· Control industrial: Cipuri principale pentru PLC, module de control robotic (rezistență la temperaturi ridicate).
· Automotive: Procesoare ADAS, circuite integrate pentru sistemul de management al bateriei (BMS) în vehicule electrice (EV) (rezistență la vibrații).
· Electronice de consum: Procesoare pentru smartphone/laptop, cipuri pentru dispozitive IoT (design dens).
Avantaje:
Permite miniaturizarea electronicii de înaltă performanță.
Gestionarea mai bună a căldurii în comparație cu pachetele tradiționale (QFP, DIP).
Rezistent la stresul mediului (vibrații, cicluri de temperatură).

KING FIELD dispune de capacități puternice și cuprinzătoare în asamblarea BGA, acoperind mai multe aspecte precum susținerea diverselor tipuri de ambalare, montarea de înaltă precizie, testarea și reparația profesională, precum și adaptarea la producția de masă în multiple domenii. Capacitățile specifice sunt următoarele:
Compatibilitate cu diverse tipuri de pachete BGA
KING FIELD susține diverse tipuri de pachete BGA (µBGA, vfBGA, CSP, WLCSP, LGA), gestionând BGAs cu pas extrem de fin de 0,2 mm și peste 1000 de bile, pentru a satisface nevoile de asamblare a cipurilor cu densitate mare și număr mare de pini pentru electronice premium.
Montare de înaltă precizie și înaltă eficiență
KING FIELD utilizează linii SMT de mare viteză (Yamaha YSM20R/YS24) cu o precizie de poziționare de ±0,04 mm (suportă componente 0201). Având o capacitate robustă (peste 30 de milioane de puncte zilnic pentru plăci PCB medicale, peste 15 milioane pentru plăci PCB proiectoare), satisface
necesitățile de producție în serie mică și mare, precum și asamblarea BGA dublu fațetă pentru o integrare mai ridicată a PCB-urilor.
Sistem complet de testare a calității
KING FIELD dispune de echipamente profesionale complete de testare: teste X-ray detectează defectele ascunse ale lipiturilor BGA (lipituri reci, goluri), combinate cu AOI, 3D-SPI, ICT pentru testare multi-etapă (de la pasta de lipit până la produsul finit), asigurând asamblarea BGA
calitate.
Capacități profesionale de reparații
KING FIELD are stații dedicate pentru reparații BGA, care permit eliminarea/înlocuirea profesională a componentelor BGA defecte, reducând pierderile în producție și asigurând o calitate stabilă a livrărilor.
Adaptabilitate la scenarii profesionale multifuncționale
KING FIELD deține certificatele IATF 16949/ISO 13485, oferind asamblări BGA care respectă cerințele stricte ale industriei. Cu o experiență vastă în asamblarea plăcilor de bază pentru proiectoare/medicale de înaltă gamă, soluțiile sale sunt utilizate în domeniul industrial
control, electronice auto, casă inteligentă și rezistă la vibrații/temperaturi ridicate.
Servicii Suport Unic
KING FIELD oferă servicii complete PCB/PCBA: asamblare BGA plus aprovizionare componente, optimizare design DFMA etc. Colaborăm cu furnizori premium globali, simplificând lanțurile de aprovizionare ale clienților și sporind eficiența proiectelor.

Capacitate de producție
| Tipuri de asamblare |
● Asamblare SMT (cu inspecție AOI); ● Asamblare BGA (cu inspecție cu raze X); ● Asamblare prin găuri pasante; ● Asamblare mixtă SMT și prin găuri; ● Asamblare kit |
||||
| Inspecția calității |
● Inspecție AOI; ● Inspecție cu raze X; ● Test de tensiune; ● Programare cip; ● Test ICT; Test funcțional |
||||
| PCB | PCB rigid, PCB cu nucleu metalic, PCB flexibil, PCB rigid-flexibil | ||||
| Tipuri de componente |
● Pasive, dimensiune minimă 0201(inch) ● Cipurile cu pas fin până la 0,38 mm ● BGA (pas 0,2 mm), FPGA, LGA, DFN, QFN cu testare prin raze X ● Conectori și terminale |
||||
| Sursă de Componente |
● Cheie în mână completă (Toate componentele furnizate de Yingstar); ● Cheie în mână parțială; ● Kitat/Furnizat |
||||
| Tipuri de lipituri | Cu plumb; Fără plumb (RoHS); Pasta de lipit solubilă în apă | ||||
| Cantitate de comandă |
● De la 5 bucăți la 100.000 bucăți; ● De la prototipuri la producție de masă |
||||
| Timp de așteptare pentru asamblare | Între 8 ore și 72 de ore după ce piesele sunt gata | ||||
Capacitatea procesului de fabricație a echipamentelor
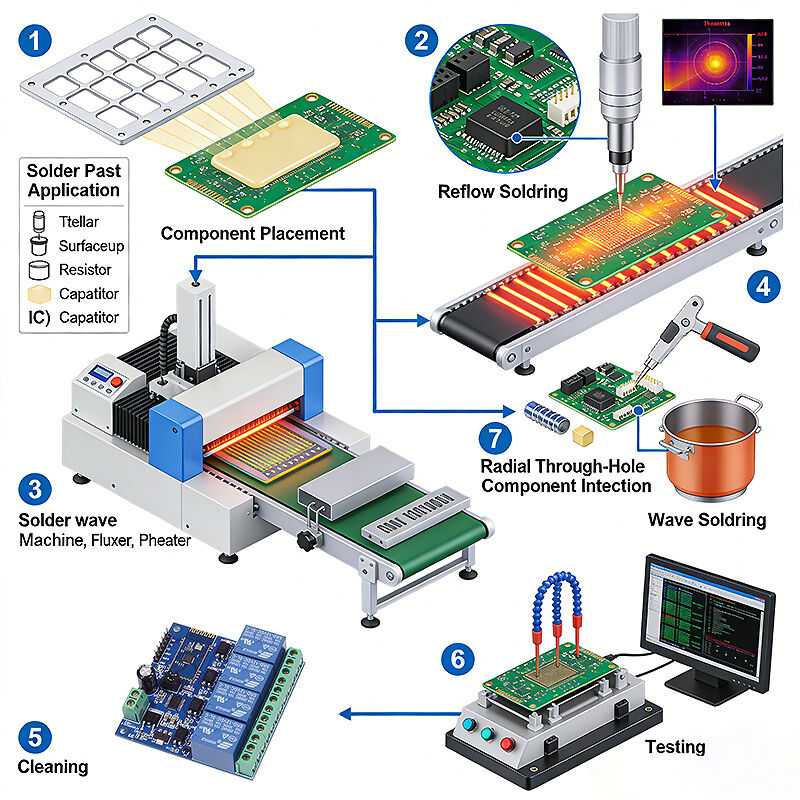
| Capacitate SMT | 60.000.000 de cipuri/zi | ||||
| Capacitate THT | 1.500.000 de cipuri/zi | ||||
| Termen de livrare | Expediere rapidă în 24 de ore | ||||
| Tipuri de PCB-uri disponibile pentru asamblare | Plăci rigide, plăci flexibile, plăci rigid-flex, plăci din aluminiu | ||||
| Specificații PCB pentru asamblare | Dimensiune maximă: 480x510 mm; Dimensiune minimă: 50x100 mm | ||||
| Componentă minimă pentru asamblare | 03015 | ||||
| BGA minim | Plăci rigide 0,3 mm; Plăci flexibile 0,4 mm | ||||
| Componentă cu pas fin minim | 0.3 mm | ||||
| Precizia poziționării componentelor | ±0,03 mm | ||||
| Înălțime maximă componentă | 25 mm | ||||




